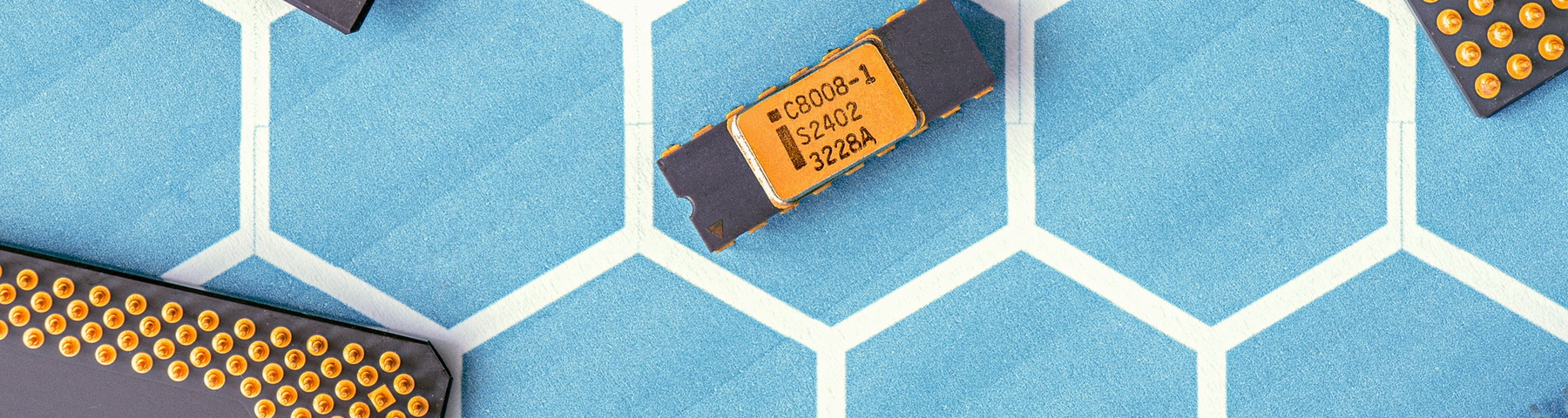
氧化硅片 Silicon Thermal Oxide Wafer
国际品牌、品质保障!
产品概览

硅片的热氧化层是在有氧化剂的高温条件下在硅片的裸片表面形成的氧化层或者二氧化硅层。硅片的热氧化层通常在水平管式炉中生长而成,生长温度范围一般为900℃~1200℃,有“湿法氧化”和“干法氧化”两种生长方式。热氧化层是一种“生长”而成的氧化物层,相较于CVD沉积的氧化层,它具有更高的均匀性和更高的介电强度。热氧化层是作为绝缘体的优异的介电层,在众多硅基器件中,热氧化物层在作为掺杂阻止层和表面电介质方面起着重要作用。
英创力科技提供2“~12”高质量的热氧化硅片,与我们合作的生厂商均选用优质、无缺陷的产品级硅片作为基底来生长高均匀性的热氧化层。以满足超越客户期望的性能。
采用常规热氧化工艺后,硅片的双面均有氧化层;如果只需单面氧化层,我们可采用研磨的办法去除一面氧化层而仅保留单面氧化层供货!
Tips:氧化类型
1.干法氧化
硅与氧发生反应,氧化层不断朝向基底层的移动。干法氧化需在850至1200℃的温度下进行,生长速率较低,可用于MOS绝缘栅极生长。在需要高质量、超薄硅氧化层的情况下,干法氧化相较于湿法氧化是优选方案。
干法氧化能力:15nm~300nm(150Å~3000Å)
2.湿法氧化
该方法使用氢气和高纯度氧气混合物在~1000℃下燃烧,从而产生水蒸气来形成氧化层。虽然湿法氧化无法产生如干法氧化一样高质量的氧化层,但足够用以作为隔离区,相比较于干法氧化具有明显的优势是其有更高的生长速率。
湿法氧化能力:50nm~15 µm(500Å~15µm)
3. 干法-湿法-干法
该方法采用初始阶段向氧化炉中释放纯干氧,氧化中段加放氢气,尾段再停放氢气以纯干氧继续氧化的工艺形成较一般以水蒸汽形式的湿法氧化工艺更致密的氧化结构。
4. TEOS氧化
工艺能力

规格表
| Oxidation Technique 氧化工艺 |
Wet oxidation or Dry oxidation 湿法氧化/干法氧化 |
|---|---|
| Diameter 硅片直径 |
2″ / 3″ / 4″ / 6″ / 8″ / 12″ 英寸 |
| Oxide Thickness 氧化层厚度 |
100 Å ~ 15µm 10nm~15µm |
| Tolerance 公差范围 |
+/- 5% |
| Surface 表面 |
Single Side Oxidation(SSO) / Double Sides Oxidation(DSO) 单面氧化/双面氧化 |
| Furnace 氧化炉类型 |
Horizontal tube furnace 水平管式炉 |
| Gas 气体类型 |
Hydrogen and Oxygen gas 氢氧混合气体 |
| Temperature 氧化温度 |
900℃ ~ 1200 ℃ 900 ~ 1200 摄氏度 |
| Refractive index 折射率 |
1.456 |
典型应用
>> 隧道栅极 Tunneling Gate
>> 栅极氧化 Gate Oxides
>> 硅局部氧化隔离氧化垫 LOCOS Pad Oxide
>> 掩膜氧化 Masking Oxides
>> 场氧化 Field Oxides
知识库
氧化硅膜的颜色随厚度不同而呈现不同的色彩,下图提供了不同厚度的氧化硅的颜色图卡供参考。
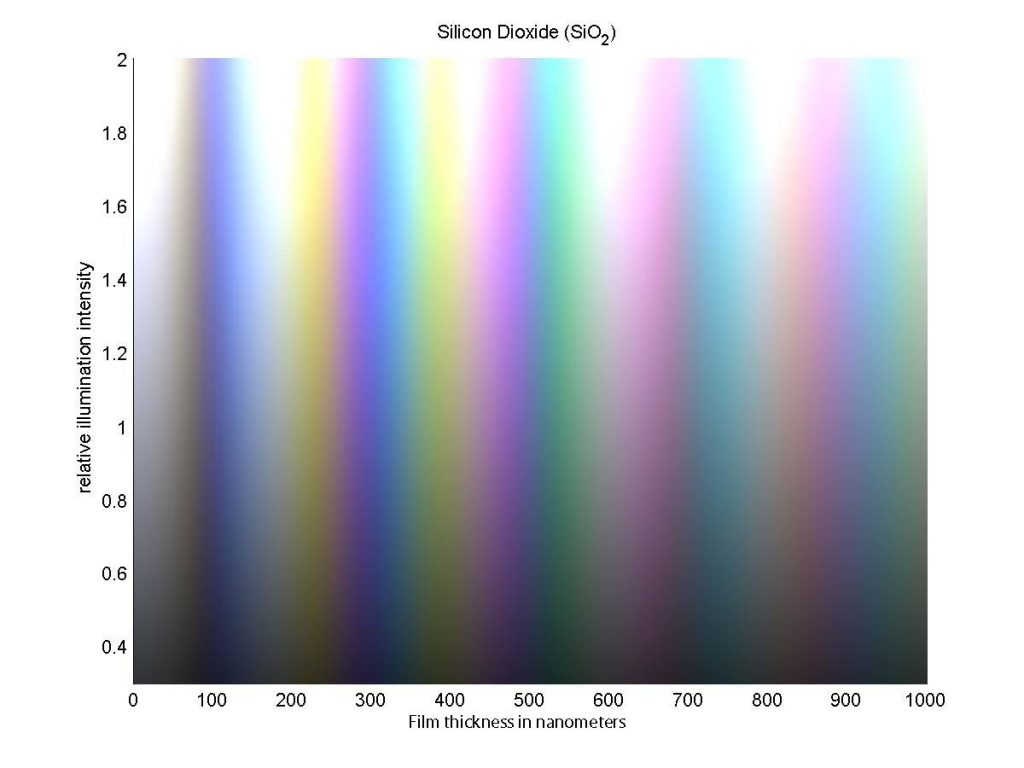
在线询价
电话&邮件询价
联系电话:18600564919
邮件:sales##innotronix.com.cn (用@替代##即可)